はじめに
今回は、「フォトレジスト」をはじめとした、半導体製造工程のフォトリソグラフィー工程で使用される薬品に関連した国内主要メーカーをまとめてみました。その他の半導体関連の企業は以下のブログにまとめていますので、ぜひご覧ください!
概要
フォトリソグラフィーとは
フォトリソグラフィーとは、光を使って回路パターンをウェーハ上に形成する技術です。主に以下の工程から成り立っています。
1.フォトレジストの塗布:ウェーハを回転させながら、その上に均一に塗布する。
2.露光:回路が描写されたフォトマスクの上から光を照射し、ウェーハに回路を転写する。
3.現像:保護膜とならない余分なレジストの除去。
4.エッチング:レジストを保護膜として、レジストの無い部分を削り取る。
5.フォトレジストの除去:保護膜の役割を終えたレジストの除去。
フォトレジストとは
フォトレジスト(Photoresist)とは、Photo(光)とResist(耐える)の2単語から成る造語であり、光を使って回路パターンをウェーハ上に形成するフォトリソグラフィー工程で使用される薬品です。ポリマー(樹脂)・感光剤・溶剤・添加剤を主成分として光に反応してエッチングに耐える性能を持ち、これに回路パターンを露光・現像し、ウェーハ上にパターンを転写します。半導体製造では大きく2つの場面で使用されており、ウェーハ工程(前工程)では光(紫外線)に反応するものが、フォトマスク製造工程では電子線(EB)に反応するものが使用されています。また、光や電子線への反応形態から、大きく「ネガ型」と「ポジ型」に分けられます。
「ネガ型」:露光部分が現像液に溶解せずパターンとして残り未露光部が溶解するタイプ。
「ポジ型」:露光部分が現像液に溶解して未露光部がパターンとして残るタイプ。
現在の半導体製造においてはポジ型が主流となっている。この理由としては、ネガ型の場合には現像時に溶剤がレジストを膨潤させることから微細配線への対応が難しくなるためです。
また、フォトレジストは光との反応を利用してパターニングされるため、以下のような光の種類(光源・波長)によっても分類されます。
高圧水銀ランプ
・g線:436 nm
・h線:405 nm
・i線:365 nm
エキシマレーザー
・KrF:248 nm
・ArF:193 nm
EUV(極端紫外線):13.6 nm
電子線(EB)
現像液とは
現像液とは、ウェーハ上に回路を転写する露光工程の後に不要になったフォトレジストを溶解・除去するための薬液です。現像液を除去するためのリンス液とセットで使用されます。取り除くフォトレジストの種類(ネガ or ポジ)に応じて、以下のような使い分けがなされます。
ネガ型の場合
多くの場合は有機溶剤が使用されます。レジスト成分を有機溶剤で膨潤させることから、現像後には同じく溶剤のリンス液が必要となります。
ポジ型の場合
主にアルカリ現像液が用いられます。アルカリ現像液として通常はTMAH(テトラメチルアンモニウムハイドロオキサイド)を用います。リンス液は純水を使用します。
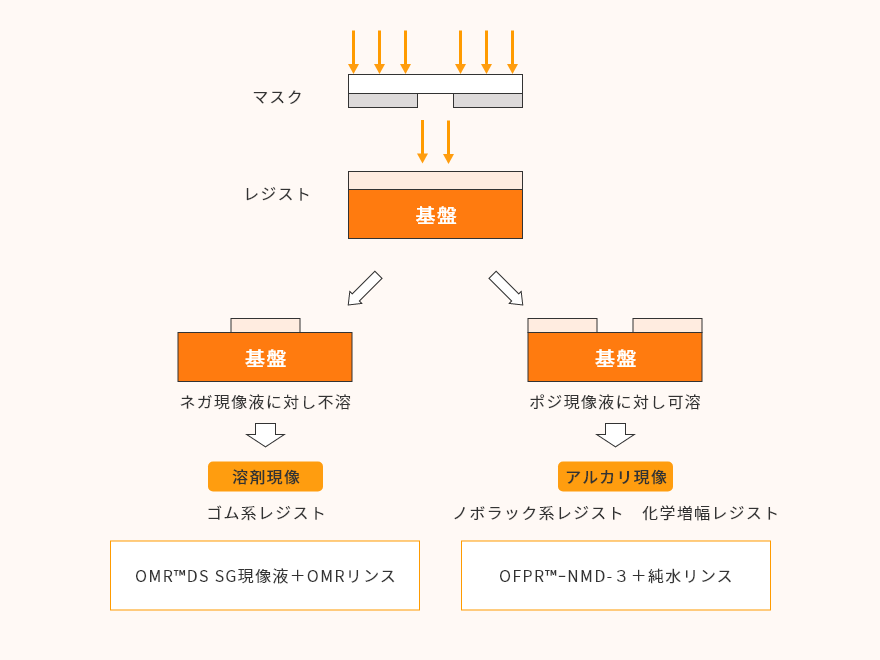
剥離液とは
剥離液とは、エッチング後に不要となったフォトレジストを除去するための薬液です。また、エッチング後のデポ物(回路周辺に堆積した微粒子や塵)を除去するためにも用いられます。
フォトレジストメーカー
以下のメーカー5社は、g・i専用、KrF・ArF・ArF液浸用・EUV用・EB用と幅広い範囲のフォトレジストを生産しており、以下の5社で世界シェアの90%以上を占めています。
4063:信越化学工業
4186:東京応化工業
4185:JSR
4005:住友化学
4901:富士フィルム
フォトレジスト原料メーカー
4041:日本曹達
4044:セントラル硝子
フッ素含有モノマー及びフッ素含有ポリマー
4113:田岡化学工業
2,3-キシレノール、3,4-キシレノール
4187:大阪有機化学工業
レジスト原料であるアクリルモノマー
4188:三菱ケミカル
フォトレジスト用感光性ポリマー「リソマックス」
4202:ダイセル
10種類以上の自社モノマーを含む各種モノマーを組み合わせたフォトレジスト用ポリマー
4203:住友ベークライト
フォトレジスト用フェノールレジン
4216:旭有機材
フォトレジスト原料の高純度フェノール樹脂・フェノール誘導体
4229:群栄化学工業
フォトレジスト用レヂトップ、ノボラック型フェノール樹脂
4366:ダイトーケミックス
フォトレジストに使用される感光性材料
4401:ADEKA
フォトレジスト用光酸発生剤
4410:ハリマ化成
フォトレジスト用樹脂
4631:DIC
4901:富士フィルム(富士フィルム和光純薬)
4970:東洋合成工業
フォトレジスト用感光性化合物
フォトレジスト用ポリマー
東京化成工業
フォトポリマー試薬(光反応性高分子用試薬)、光重合開始材
丸善石油化学(コスモ石油の傘下)
半導体フォトレジスト用ポリマー
現像液・リンス液
剥離液
液浸露光用トップコート
4185:JSR





コメント