はじめに
今回は、半導体デバイスが出来上がるまでの一連の流れ「半導体製造工程」についてまとめてみました。半導体製造工程は大きく「前工程」と「後工程」の2つに分類されます。最初のほうでは2つの工程について簡単に説明し、後半のほうでより詳しく説明していきます。
前工程・後工程とは(概略)
前工程
前工程を一言で表すと、「ウェーハ加工工程」です。主に以下の工程で構成されています。
1.ウェーハ表面の酸化
2.薄膜形成
3.フォトレジスト塗布
4.露光・現像
5.エッチング
6.レジスト剥離・洗浄
7.イオン注入
8.平坦化
9.電極形成
10.ウェーハ検査
後工程
後工程を一言で表すと、「組立・試験工程」です。大きくつ5の工程で構成されています。
1.ダイシング :回路が形成されたウェーハから半導体チップ(ダイ)を切り出す。
2.ダイボンディング :リードフレーム上にダイを固定する。
3.ワイヤボンディング:固定されたダイに電極を接続する。
4.パッケージング :セラミックスや樹脂で包装(封入)する。(モールディング)
5.最終検査 :電気的特性検査や外観構造検査などを行う。
前工程の詳細
ウェーハ表面の酸化
800~1200℃の高温中でシリコンウェーハ表面を酸素もしくは水蒸気にさらすことで、絶縁層である二酸化ケイ素(SiO2)膜をを形成する。この絶縁酸化膜は、下地のSi中へ選択的に不純物を導入するために形成される。
薄膜形成
シランとアンモニアガスを流入し、CVD(Chemical Vapor Deposition)法により酸化膜上に窒化膜を形成する。
フォトレジスト塗布
コータによってウェーハを高速回転させながら、フォトレジスト(UV光によって性質の変化する感光材)をウェーハ前面に均一に塗布する。
露光・現像
フォトマスク(IC回路が描画されたガラス製のマスク)をウェーハに合わせ、露光装置を使用してUV光を当て、フォトレジスト上に転写する。
その後、デベロッパによって現像液をウェーハ前面に均一に塗布し、回路パターンを形成する。ポジ型レジストでは光の当たった箇所、ネガ型レジストでは光の当たらなかった箇所のフォトレジストが溶ける。
エッチング
プラズマエッチング装置を使用して、フォトレジストで形成されたパターンに沿って膜を削り取る(エッチングする)。フォトレジストで保護されている部分は削られない。
レジスト剥離・洗浄
アッシング装置(プラズマもしくはオゾン)を使用して、エッチング後に不要になったフォトレジストを除去する。また、洗浄装ウェーハを薬液に浸して洗浄し、表面の不純物を除去する。
絶縁層埋め込み
プラズマCVD装置やスピンコータを使用し、酸化膜を堆積させて層間絶縁膜を形成する。その後、ガスケミカルエッチング装置もしくは洗浄装置により、表面を平坦化する。
ゲート形成
熱酸化法でゲート絶縁膜(酸化膜)を形成し、続いてその表面に窒化処理を施す。その後、CVD法によりゲート電極層(多結晶シリコン膜)を形成する。
ソース・ドレイン形成(イオン注入)
ゲート電極上にパターン形成プロセス(レジスト塗布・露光・現像など)を施し、ソース・ドレイン領域を形成する。
その後、イオン注入装置によってソース・ドレイン領域に元素(ホウ素・ヒ素・リンなど)を打ち込み、高温アニールによって元素を均一に拡散させる。イオン打ち込み法では、イオン化された元素を高加速電圧で衝突させ、物理的に侵入させる。その際、イオンの通過した部分のシリコン単結晶は破壊されるため、アニールによって結晶性回復を行う。アニール温度が高い場合は結晶性回復と同時に、熱拡散により元素がシリコン結晶内に入り込んで活性化される。
平坦化
減圧(LP)CVD法により酸化膜を形成させ、CMP装置により表面を研磨して平坦にする。
電極形成
酸化膜上にパターン形成プロセス(レジスト塗布・露光・現像など)を施し、コンタクトホール(電極形成箇所)を形成する。その後、CVD法やPVD法(スパッタリング)により、コンタクトホールに金属電極を形成する。余分な膜はCMP装置で研磨する。
配線形成
低誘電率層間絶縁膜(low-k)を堆積させ、そこにトレンチ(配線となる部分)を開口する。このトレンチにメタル膜形成装置(CVD、PVD、めっき装置)を用いて金属膜を埋め込み、余分な膜を研磨して除去する。
この一連の流れを、必要な配線総数分繰り返す。
ウェーハ検査
プロービング装置を使用して、ウェーハ上に形成された一つ一つのチップにプローブ針を接触させてチップの良/不良を電気的に検査する。加えて、外観検査装置や欠陥検査装置を用いて、ウェーハ表面の検査を実施する。
後工程の詳細
グラインディング
バックグラインド装置を使用し、パッケージに収容可能な厚さまでウェーハの裏側を削る。
ダイシング
複数の回路が形成されたウェーハから半導体チップ(ダイ)を切り出す。
ダイボンディング
半導体素子(ダイ)を支持体に固定する。
ワイヤボンディング
ダイとインナーリードを金線でで都合する。
モールディング(パッケージング)
エポキシ樹脂でダイを包装(封入)する。
最終検査
title
各工程での製造装置
前工程・後工程でそれぞれ使用される製造装置と、その主要メーカーを以下の記事にまとめています。ぜひご覧ください!


【参考】
Nanotec Museum;[常設展Ⅲ]半導体のできるまで, 東京エレクトロン
半導体製造工程とは, 一般社団法人日本半導体製造装置協会
半導体の部屋; 半導体の製造; 1.半導体製造工程, 日立ハイテク
半導体ができるまで, ルネサスエレクトロニクス
SEMI FREAKS; イラストで分かる半導体製造工程, semi
半導体製造プロセス, SCREEN ホールディングス
半導体製造に見るJSR, JSRマイクロニクス九州
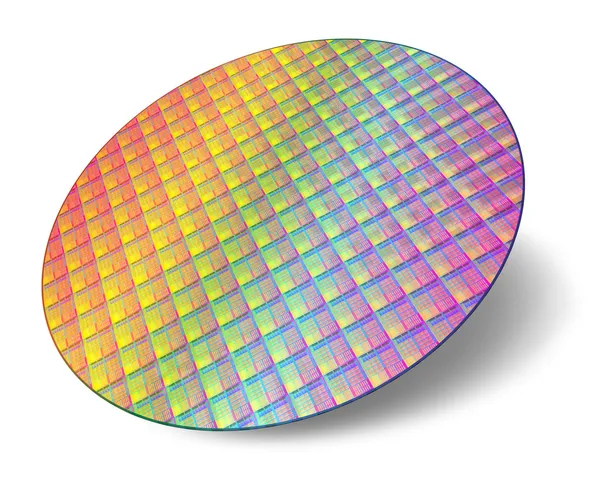


コメント